近期,在北美技术论坛这一科技盛会上,台积电首次披露了其N2 2nm工艺的关键性能指标——缺陷率(D0)的最新进展。据悉,N2工艺的缺陷率表现远超之前的7nm、5nm及3nm等先进制程。
尽管台积电并未透露具体的缺陷率数据,但通过对比不同工艺缺陷率随时间变化的趋势图,可以清晰地看到N2工艺的优势所在。这一趋势图展示了从早期试产到接近量产阶段,各工艺缺陷率的演变情况。
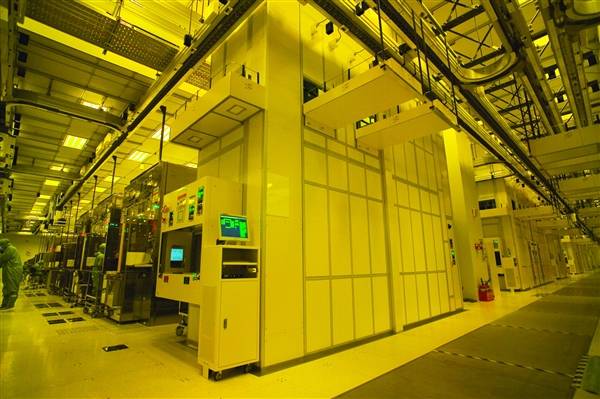
值得注意的是,N2工艺首次采用了GAAFET全环绕晶体管技术,这一创新为台积电在半导体制造领域树立了新的里程碑。目前,N2工艺距离大规模量产还有两个季度的时间,预计将在今年年底正式投产。
在N2工艺的近两个月试产期间,其缺陷率表现与同期的N5/N4工艺相当,甚至略胜一筹。与更早的N7/N6以及N3/N3P工艺相比,N2的缺陷率更是显著更优。从历史数据来看,N7/N6工艺在试产到量产的半年内,综合缺陷率一直居高不下;而N3/N3P工艺从量产初期就展现出了较低的缺陷率;N5/N4工艺则更为出色,从试产阶段就保持了较低的缺陷率水平。
若N2工艺能够延续N5/N4的优异表现,其市场前景无疑将十分广阔。台积电方面还指出,工艺的缺陷率能否迅速降低,不仅取决于工艺本身的设计和技术水平,还与芯片制造数量和产能规模密切相关。大规模的芯片生产能够更容易地发现并改进缺陷,从而提升整体工艺质量。
事实上,台积电在N2工艺上已经流片了数量可观的芯片,这也是其能够快速降低缺陷率的关键因素之一。通过不断的试验和改进,台积电正稳步迈向2nm工艺的大规模量产。





















